







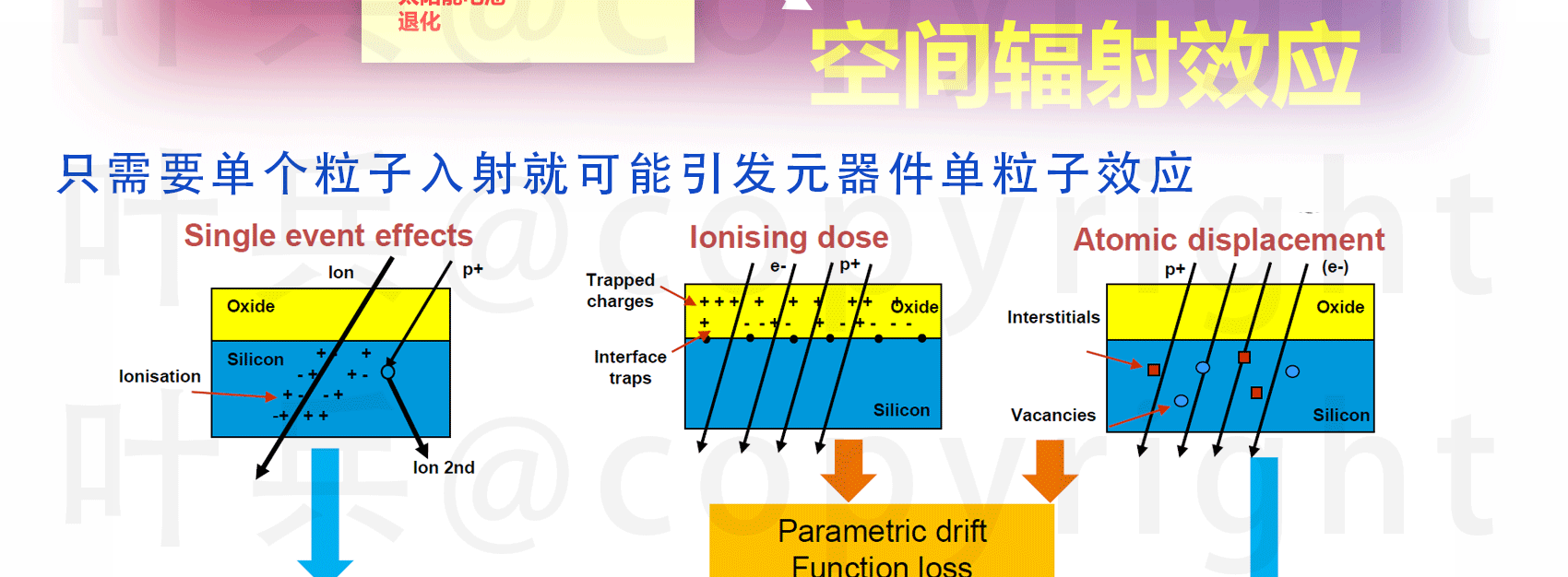







发表论文
Characteristics of secondary ions and their impact on single-event upset in TMD devices under proton irradiation, NIMB, 2024, 第1/通讯作者
Exploring the Impact of Shrinking Feature Sizes on Proton-Induced Saturation SEU Cross-Section through Simulation,MICROELECTRONICS RELIABILITY, 2023, 第1/通讯作者
Investigation of radiation response for III-V binary compound semiconductors due to protons using Geant4, NIMB, 2022, 第1/通讯作者
Differences in MBUs induced by high-energy and medium-energy heavy ions in 28 nm FPGAs, NUCL SCI TECH, 2022, 通讯作者
Effect of Temperature on the Heavy Ion Induced Single Event Transient on 16 nm FinFET Inverter Chains, CHINESE PHYSICS B, 2022, 通讯作者
Neutron-induced single event upset simulation in Geant4 for three-dimensional die-stacked SRAM, CHINESE PHYSICS B, 2021, 通讯作者
Impact of heavy ion energy and species on single-event upset in commercial floating gate cells, MICROELECTRONICS RELIABILITY, 2021, 第1/通讯作者
Geant4 simulation of proton-induced single event upset in three-dimensional die-stacked SRAM device, CHINESE PHYSICS B, 2020, 第1/通讯作者
Influence of Orbital Parameters on SEU Rate of Low-Energy Proton in Nano-SRAM Device, SYMMETRY-BASEL, 2020, 第1/通讯作者
Impact of energy straggle on proton-induced single event upset test in a 65-nm SRAM cell, CHINESE PHYSICS B, 2017, 第 1 作者
Low energy proton induced single event upset in 65nm DDR and QDR commercial SRAMs, NIMB, 2017, 第1/通讯作者
Mechanisms of alpha particle induced soft errors in nanoscale static random access memories, ACTA PHYSICA SINICA, 2020, 第 2 作者
Heavy-ion induced radiation effects in 50 nm NAND floating gate flash memories, MICROELECTRONICS RELIABILITY, 2019, 第 4 作者
Heavy-ion and pulsed-laser single event effects in 130nm CMOS based thin/thick gate oxide anti-fuse PROMs, NST, 2019, 第 9 作者
Annealing behavior study on floating gate errors induced byγfollowed by heavy ion irradiation, 核技术, 2019, 第 6 作者
Effects of total ionizing dose on single event effect sensitivity of FRAMs, MICROELECTRONICS RELIABILITY, 2019, 第 5 作者
Impact of Total Ionizing Dose on Single Event Upset Sensitivity of Nano-SRAMs Devices, 原子核物理评论, 2019, 第 5 作者
Influences of total ionizing dose on single event effect sensitivity in floating gate cells, CHINESE PHYSICS B, 2018, 第 6 作者
Investigation of flux dependent sensitivity on single event effect in memory devices, CHINESE PHYSICS B, 2018, 第 10 作者
Heavy Ion Radiation Effects on a 130-nm COTS NVSRAM Under Different Measurement Conditions, IEEE TNS, 2018, 第 6 作者
Anomalous annealing of floating gate errors due to heavy ion irradiation, NIMB, 2018, 第 6 作者
Influences of total ionizing dose on single event effect sensitivity in floating gate cells, 中国物理B:英文版, 2018, 第 6 作者
Radiation-Induced "Fake MBU" by Heavy Ion in 65 nm SRAM with ECC, 原子核物理评论, 2018, 第 5 作者
Application of SEU imaging for analysis of device architecture using a 25 MeV/u 86Kr ion microbeam at HIRFL, NIMB, 2017, 第11作者
A comparison of heavy ion induced single event upset susceptibility in unhardened 6T/SRAM and hardened ADE/SRAM, NIMB, 2017, 第 8 作者
Influence of heavy ion flux on single event effect testing in memory devices, NIMB, 2017, 第 8 作者
Prediction of proton-induced SEE error rates for the VATA160 ASIC, NUCLEAR SCIENCE AND TECHNIQUES, 2017, 第 9 作者
Monte Carlo predictions of proton SEE cross-sections from heavy ion test data, CHINESE PHYSICS C, 2016, 第 9 作者
Impact of Heavy-ion Nuclear Reactions on Single Event Upset, Nuclear Physics Review, 2015, 第 7 作者
科研项目
( 1 ) 质子入射引起3D SRAM器件单粒子效应机理研究, 负责人, 国家任务, 2022-01--2024-12
( 2 ) 模拟IC高能重离子单粒子效应机理及试验技术研究, 负责人, 企业委托, 2022-06--2023-12
( 3 ) 器件封装材料对单粒子效应的影响, 负责人, 中国科学院计划, 2018-01--2021-12
( 4 ) 28nm CMOS工艺的单粒子翻转及软错误率研究, 负责人, 企业委托, 2018-10--2021-12
( 5 ) KJ基础XXX建设研究, 参与, 国家任务, 2022-03--2025-12
( 6 ) XXX对XXBFS效应研究, 参与, 国家任务, 2021-06--2024-06
叶兵 中国科学院大学 中国科学院近代物理研究所 副研究员 甘肃省兰州市城关区南昌路509号 硕导 理学博士 兰州大学 单粒子效应 辐射效应 重离子 加速器 仿真
